 晶圆切割——崩边原因分析及解决方法晶圆切割——崩边原因分析及解决方法 晶圆切割主要采用金刚石砂轮刀片即轮毂型硬刀,半导体从业者不断寻求能提高加工质量和加工效率的方法,以达到更低的加工成本。西斯特科技(SST)在...
晶圆切割——崩边原因分析及解决方法晶圆切割——崩边原因分析及解决方法 晶圆切割主要采用金刚石砂轮刀片即轮毂型硬刀,半导体从业者不断寻求能提高加工质量和加工效率的方法,以达到更低的加工成本。西斯特科技(SST)在...
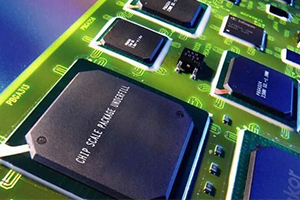 CSP先进封装技术的发展趋势近年来,CSP在业界引起较大议论,它被行业寄予厚望,被认为是一种“终极”封装形式。
CSP先进封装技术的发展趋势近年来,CSP在业界引起较大议论,它被行业寄予厚望,被认为是一种“终极”封装形式。
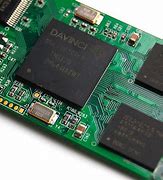 一文详解CSP先进封装技术CSP封装是封装完成后再进行切割分片,所以,封装后的芯片尺寸和裸芯片几乎一致。
一文详解CSP先进封装技术CSP封装是封装完成后再进行切割分片,所以,封装后的芯片尺寸和裸芯片几乎一致。
 北大清华深圳研究院深港产学研交流会6月29日,在深港产学研基地与北大清华深圳研究院就产学研交流进行了深入探讨。
北大清华深圳研究院深港产学研交流会6月29日,在深港产学研基地与北大清华深圳研究院就产学研交流进行了深入探讨。
 解决氧化锆陶瓷钻孔难题的上机案例氧化锆陶瓷具有高硬度、高韧性、高抗弯强度和高耐磨性,隔热性能佳,热稳定性好,广泛的应用于诸多领域的结构件与功能件,比如陶瓷手机中框、后壳,陶瓷手表壳、手表后盖等等。由于一些功能需要,往往...
解决氧化锆陶瓷钻孔难题的上机案例氧化锆陶瓷具有高硬度、高韧性、高抗弯强度和高耐磨性,隔热性能佳,热稳定性好,广泛的应用于诸多领域的结构件与功能件,比如陶瓷手机中框、后壳,陶瓷手表壳、手表后盖等等。由于一些功能需要,往往...
 诚招代理欢迎加盟本公司半导体精密切割系列产品全国范围诚邀代理商加盟,为合作伙伴创造出新的收益与市场机会,承诺为代理商提供包含产品、技术服务、售后及产品培训等方面的完整运作方案,共谋发展。“诚信经...
诚招代理欢迎加盟本公司半导体精密切割系列产品全国范围诚邀代理商加盟,为合作伙伴创造出新的收益与市场机会,承诺为代理商提供包含产品、技术服务、售后及产品培训等方面的完整运作方案,共谋发展。“诚信经...
 案例分享-硬刀切割MOS/IC芯片数据表明,在相同加工条件下,西斯特科技的3000-R-70 DCB划片刀可与竞品的3500-N1-70CC达到同样的加工效果,并且切割寿命能够优于竞品25%。
案例分享-硬刀切割MOS/IC芯片数据表明,在相同加工条件下,西斯特科技的3000-R-70 DCB划片刀可与竞品的3500-N1-70CC达到同样的加工效果,并且切割寿命能够优于竞品25%。
 问题解析-电镀磨头加工2.5D弧面玻璃通过仿形2.5D玻璃弧面轮廓制定的磨头,通常成品弧面轮廓宽度在1.2mm-2.5mm区间较多,CNC段加工一般宽度在0.9-1.8mm。
问题解析-电镀磨头加工2.5D弧面玻璃通过仿形2.5D玻璃弧面轮廓制定的磨头,通常成品弧面轮廓宽度在1.2mm-2.5mm区间较多,CNC段加工一般宽度在0.9-1.8mm。
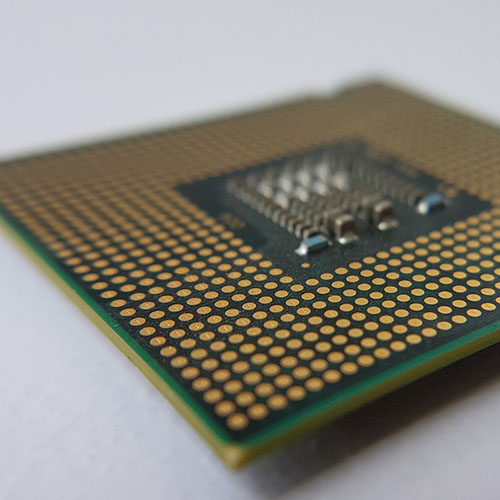 晶圆切割-常见品质缺陷及刀片选型在机械应力的作用下,晶圆切割后容易发生品质异常,品质异常常见的有:产品表面、背面Chipping、PAD氧化、分层、缺角等异常。
晶圆切割-常见品质缺陷及刀片选型在机械应力的作用下,晶圆切割后容易发生品质异常,品质异常常见的有:产品表面、背面Chipping、PAD氧化、分层、缺角等异常。
 不负春光,西斯特科技3月上海展圆满落幕Semicon半导体展以及慕尼黑电子生产设备展如期开展,于3月19日圆满落幕。
不负春光,西斯特科技3月上海展圆满落幕Semicon半导体展以及慕尼黑电子生产设备展如期开展,于3月19日圆满落幕。